半導(dǎo)體器件的發(fā)熱及溫度的分布均勻性,對于其參量的穩(wěn)定性、品質(zhì)的可靠性以及器件��、整片集成電路、整機和系統(tǒng)的壽命都有不可忽視甚至決定性的影響。因此,在器件和系統(tǒng)設(shè)計中���,熱特性測量與分析一直是非常重要的問題�。
XTDIC-Micro顯微測量系統(tǒng)----光學(xué)顯微鏡和DIC數(shù)字圖像相關(guān)技術(shù)的結(jié)合�,彌補了傳統(tǒng)設(shè)備的不足,用非接觸的數(shù)字圖像相關(guān)技術(shù)(DIC)獲取元器件熱特性參數(shù)和瞬態(tài)溫度分布場來校驗器件熱失效過程并改善仿真模型參數(shù)���。

上面是一個芯片熱變形過程���,并通過測試獲取芯片翹曲三維曲面、翹曲截線等�����,使用強大的元素功能分析獲取任意位置三維點�、線信息�。
熱學(xué)應(yīng)用——應(yīng)變測量
電路元件集成度的不斷提高,導(dǎo)致芯片的發(fā)熱功率也隨之增加���。由于非均勻交變溫度場的存在和元件組成部分間熱膨脹系數(shù)的不同�,導(dǎo)致產(chǎn)品內(nèi)部產(chǎn)生熱應(yīng)力及應(yīng)力集中問題�,熱應(yīng)變測量可提升電路可靠性。
熱學(xué)應(yīng)用——翹曲測量
芯片基板由多層復(fù)合材料組成�,各類材料熱膨脹系數(shù)不同,在溫度變化過程中���,由于芯片封裝層疊結(jié)構(gòu)及材料熱膨脹系數(shù)不匹配�����,高溫下封裝翹曲�����、表面貼裝集成電路會產(chǎn)生翹曲現(xiàn)象�����,測量翹曲參數(shù)對于封裝結(jié)構(gòu)設(shè)計及材料選型具有重要意義�����。
熱學(xué)應(yīng)用——CTE測量
CTE(膨脹系數(shù))是直接體現(xiàn)電路板性能的參數(shù)之一�。由于PCB基板和焊接到PCB上的硅芯片存在膨脹率差異,當PCB和芯片同時受熱�,PCB膨脹更劇烈,會導(dǎo)致焊點從芯片上脫落�,對于PCB板在不同溫度下微小位移和應(yīng)變測試可提升產(chǎn)品良率和可靠性。
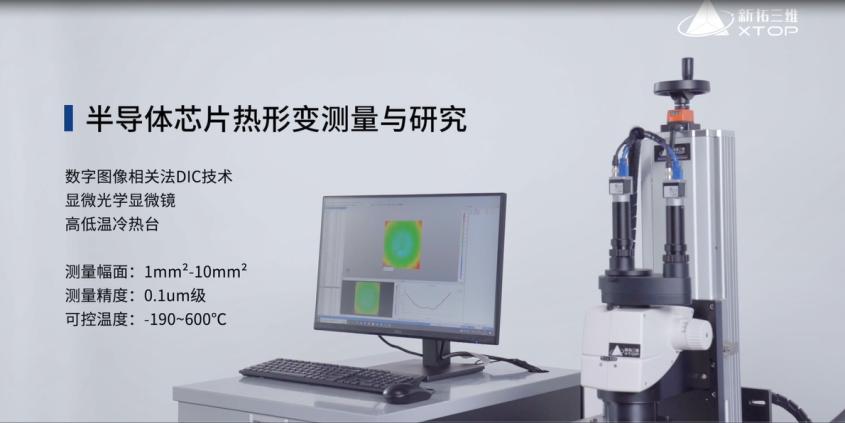
元器件熱變形測量

芯片截面的面內(nèi)應(yīng)變

芯片熱翹曲測試
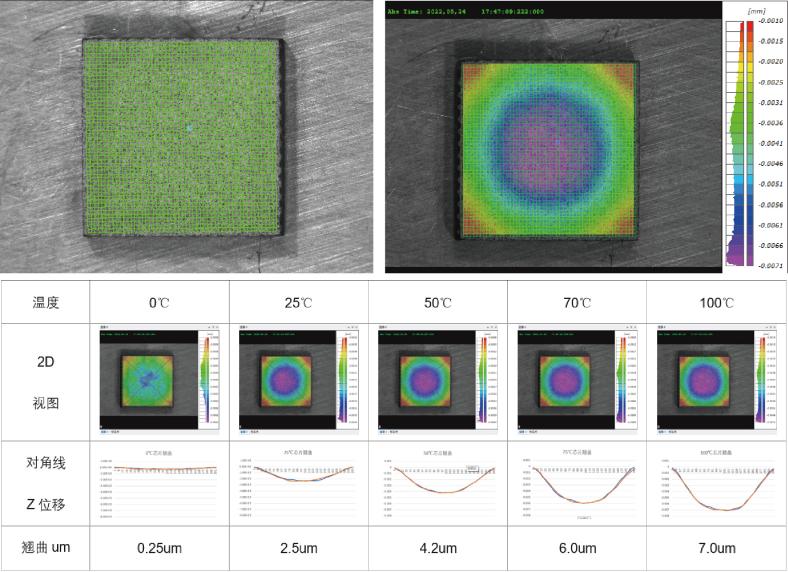
印刷電路板銅箔陶瓷板面內(nèi)應(yīng)變
