單晶硅CTE的精確測量和控制,對于確保器件性能和穩(wěn)定性至關重要。在半導體器件制造過程中��,單晶硅作為襯底材料,CTE值需與晶體薄膜的CTE值相匹配����,以避免晶體薄膜在溫度變化時出現(xiàn)應力變形���,從而影響器件性能���。在MEMS器件中,單晶硅通常作為結構材料��,其CTE值對于器件的尺寸穩(wěn)定性和性能穩(wěn)定性同樣具有重要影響����。

新拓三維XTDIC-MICRO顯微應變測量系統(tǒng),可搭配光學冷熱臺(-190℃—600℃)�����,用于微觀尺度的材料力學測試���,及芯片半導體材料和器件的熱膨脹系數(shù)���、翹曲和位移�����、應變等參數(shù)的測試分析�,具有精度高�、體積小等優(yōu)點。

XTDIC-MICRO顯微應變測量系統(tǒng)技術參數(shù):
顯微DIC技術用于膨脹參數(shù)CTE測定
單晶硅的CTE值可能會隨著溫度的變化而發(fā)生變化。因此�,在實際應用中,需要根據(jù)具體的工作溫度范圍來選擇合適的單晶硅材料�,并對其進行相應的CTE測試和控制。
為了測定單晶硅CTE值����,采用XTDIC-MICRO顯微應變測量系統(tǒng),與數(shù)控溫度控制的光學冷熱系統(tǒng)相結合���,實現(xiàn)單晶硅高溫環(huán)境下的非接觸式膨脹參數(shù)測量�����。
測試目的
采用顯微DIC應變測量系統(tǒng)�,在不同溫度環(huán)境下評估單晶硅CTE系數(shù),并記錄測試過程以及測試結果���,相關的試驗數(shù)據(jù)可用于驗證解析模型的正確性���。

單晶硅試樣表面制作散斑
顯微DIC測量精確度測試驗證
實驗開始前,使用晶體硅試樣����,對顯微DIC測量系統(tǒng)設備準確度分析�����,已知單晶硅CTE值為:2.62×10^(-6)/℃(引自《集成電路入門》�,P.13),以此進行DIC顯微測量準確度確認��。
新拓三維顯微DIC測量系統(tǒng)測得數(shù)據(jù)精度較高�����,初始狀態(tài)對比數(shù)據(jù):
X 向平均分布:2.75E-06~2.94E-06
Y 向平均分布:2.65E-06~2.88E-06
單晶硅 CTE實驗過程
(1) 試驗前,先將單晶硅測試樣品進行單次熱處理�,以消除產(chǎn)品試樣內應力影響。
熱處理條件:分別在光學冷熱系統(tǒng)將單晶硅試樣溫度降至20°C(液氮降溫)�����,然后提升至50°C�����、75℃���、100℃����、125℃��,中間保持2-5min���,溫度保持完成后���,DIC顯微測量系統(tǒng)分別以1Hz采集速率采集10張圖片��。
X��,Y分別9條等距��;邊緣留100um����,方向:圓形Mark點向右�,計算并記錄X,
Y 方向不同位置的CTE��,(溫度達到 125℃��,穩(wěn)定2min�,取10數(shù)據(jù)點的平均值);
采用DIC軟件分析采集的圖像���,可獲取X、Y方向不同位置的CTE�。熱脹系數(shù)CTE,通常采用線性膨脹系數(shù)衡量����,定義為:單位溫度改變下長度的增加量與原長度的比值��,如Z-CTEZ+��。CTE值越低��,尺寸穩(wěn)定性越好�����,反之越差����。
DIC軟件CTE分析:X向數(shù)據(jù)分析
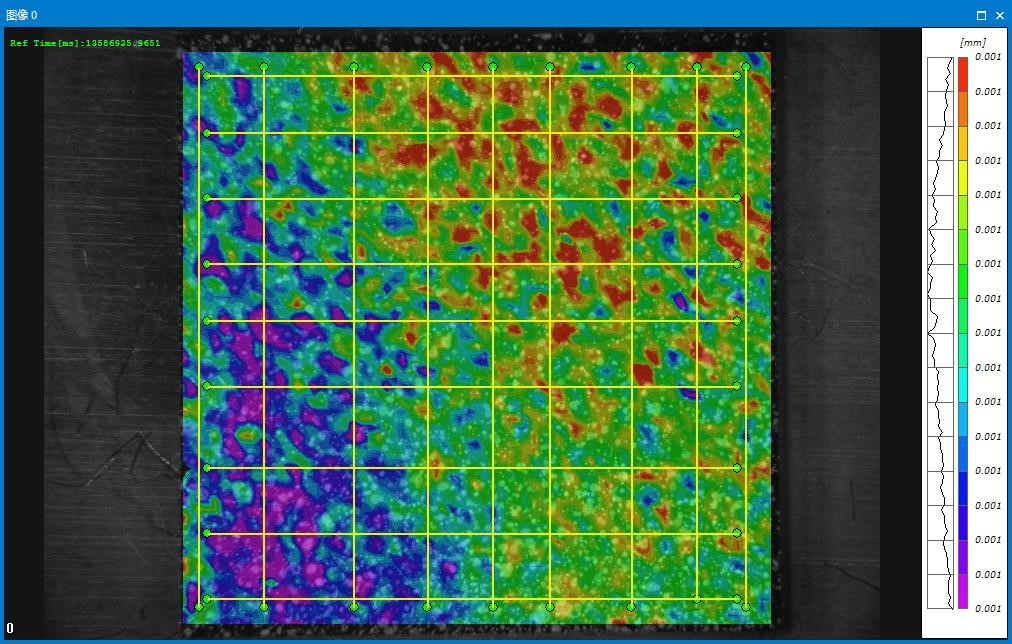
數(shù)據(jù)分析分為兩種計算方案���,一種為與前狀態(tài)數(shù)據(jù)進行對比��,分析CTE�����。一種是各狀態(tài)與初始狀態(tài)進行對比���,分析CTE。
X 方向(橫向)

與上一狀態(tài)對比分析CTE
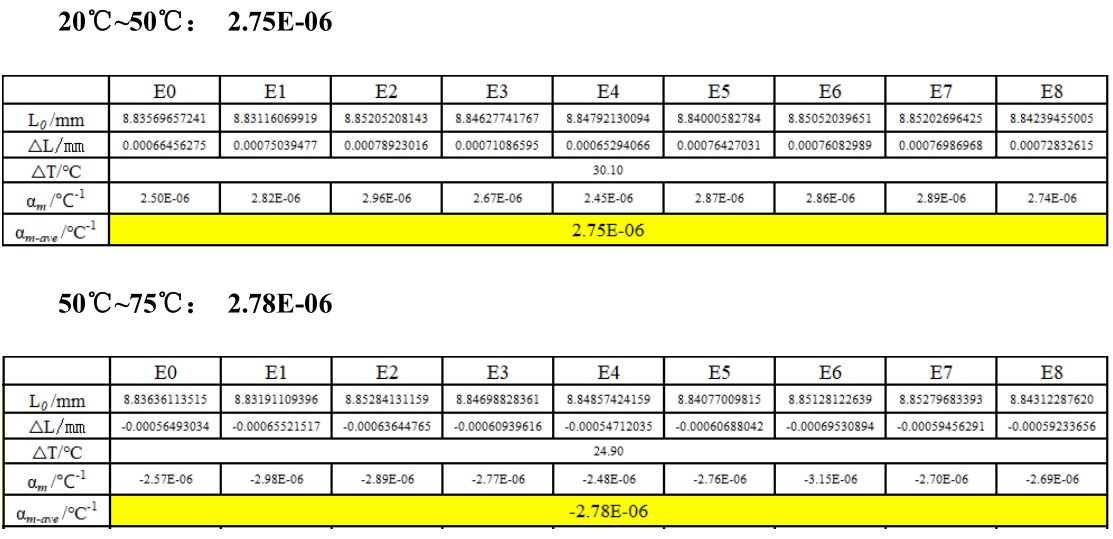
75℃~100℃: 3.12E-06

與初始狀態(tài)對比分析CTE
20℃~50℃: 2.75E-06

50℃~75℃: 2.76E-06


Y向數(shù)據(jù)分析

數(shù)據(jù)分析分為兩種計算方案���,一種為與前狀態(tài)數(shù)據(jù)進行對比���,分析 CTE�����。一種是各狀態(tài)與初始狀態(tài)進行對比��,分析 CTE�����。
Y 方向(橫向)

與上一狀態(tài)對比分析CTE

75℃~100℃: 3.04E-06
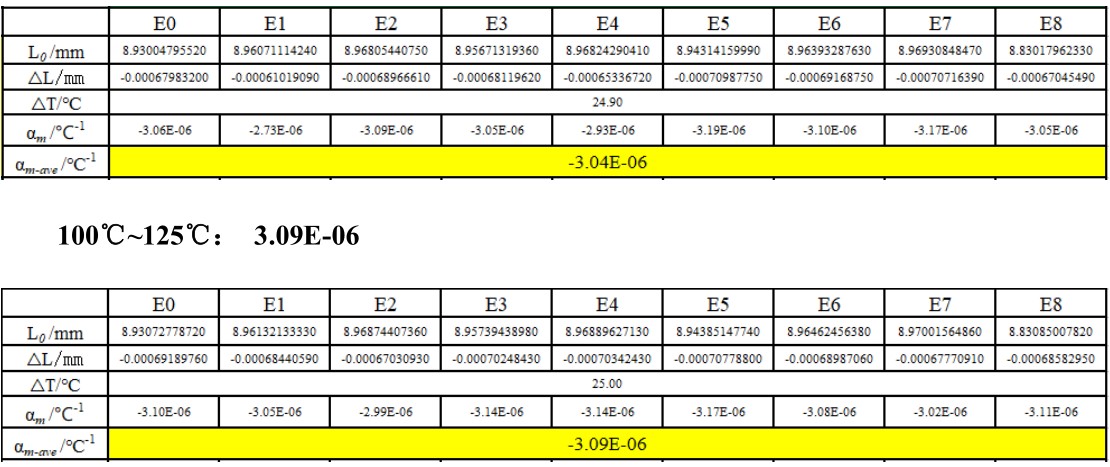
與初始狀態(tài)對比分析CTE


顯微DIC測量系統(tǒng)實測軟件界面:

變量與溫度/應變的關系圖:

說明:此段由于中間刪除 10 張照片導致缺失部分照片�����,從而坡度較大

單晶硅試樣在25°�,50°�����,100°����,125℃溫度下的應變分布圖
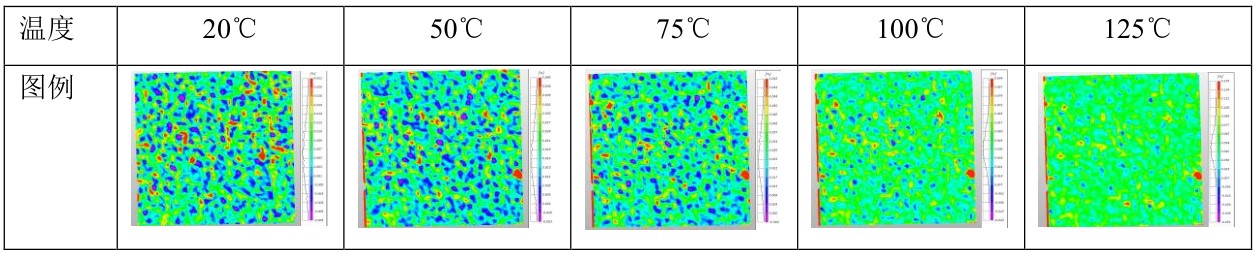
單晶硅的熱膨脹系數(shù)是一個非常重要的參數(shù),其大小余晶體的結構密切相關����。在生產(chǎn)制造和科研應用中,需充分了解單晶硅的熱膨脹性質��,以便在實際操作中減少由于熱膨脹導致的變形和損壞�。
采用新拓三維XTDIC-MICRO顯微應變測量系統(tǒng),結合光學冷熱臺��,在高低溫環(huán)境下對單晶硅進行熱膨脹CTE測試��,DIC軟件分析輸出X�����、Y方向不同位置的CTE���,分析單位溫度改變下長度的增加量與原長度的比值�,為分析單晶硅熱膨脹系數(shù)提供可靠的數(shù)據(jù)�。